引領TGV技術創新,國內鐳射企業領航先進封裝新風向
發佈時間:2024-05-23 16:59:47 | 來源:網易 | 作者: | 責任編輯:科學頻道
在全球半導體技術迅猛發展的今天,先進封裝技術成為推動行業進步的關鍵力量,而玻璃基板已成為重塑産業格局、決定未來勝負的重要戰場之一。作為全球領先的鐳射精密微納加工裝備製造商,帝爾鐳射宣佈其玻璃通孔鐳射設備已經在小規模生産中得到應用。
玻璃基板來襲,TGV成為核心挑戰
人工智慧、數據中心、自動駕駛汽車、5G等高性能計算技術正推動新一輪半導體增長週期。高性能計算的應用場景不斷拓寬,對算力晶片性能提出更高要求,在物理瓶頸拖慢摩爾定律步伐的情況下,先進封裝與晶圓製造技術相結合可以滿足計算能力、延遲和更高頻寬的要求,成為後摩爾時代積體電路技術發展的一條重要路徑,重要性與日俱增。
在先進封裝浪潮中,隨著對更強大計算的需求增加,半導體電路變得越來越複雜,信號傳輸速度、功率傳輸、設計規則和封裝基板穩定性的改進將至關重要。當前主流採用的塑膠基板(有機材料基板)很快就會達到容納的極限,特別是它們的粗糙表面,會對超精細電路的固有性能産生負面影響;此外,有機材料在晶片製造過程中可能會發生收縮或翹曲,導致晶片産生缺陷。隨著更多的硅晶片被封裝在塑膠基板上,翹曲的風險也會增加。
與有機基板相比,玻璃基板憑藉其卓越的平整度、絕緣性、熱性能和光學性質,為需要密集、高性能互連的新興應用提供了傳統基板的有吸引力的替代方案,開始在先進封裝領域受到關注。去年來,英特爾、三星等先後宣佈了在玻璃基板技術上的投資和佈局,英偉達、AMD、蘋果等大廠也均表示將導入或探索玻璃基板晶片封裝,使得該技術一躍成為半導體市場最受關注的焦點。
先進封裝中2.5D和3D IC整合方案是實現下一代性能要求和適用於商業産品的關鍵組成部分,超高密度的I/O連接可利用仲介層實現,最突出和最廣泛使用的仲介層類型之一是硅通孔——TSV仲介層。而在玻璃基板中,同樣通過高密度的通孔來提供垂直電連接,它們被稱為玻璃通孔(TGV),形成高品質、高密度的TGV通孔對於仲介層至關重要。
TGV成孔技術需兼顧成本、速度及品質要求,挑戰在於其需要滿足高速、高精度、窄節距、側壁光滑、垂直度好以及低成本等一系列要求。多年以來,業界及學界許多研究工作都致力於研發低成本、快速可規模化量産的成孔技術。一般而言,TGV可利用噴砂法、光敏玻璃法、聚焦放電法、電漿刻蝕法、電化學法、鐳射誘導刻蝕法等技術進行成孔製作。
截至目前,鐳射誘導刻蝕優勢明顯且已獲應用,有望在成孔技術中脫穎而出,使得鐳射刻蝕設備成為成孔工藝核心設備之一。
搶佔先機,帝爾鐳射落子TGV技術
帝爾鐳射自2008年成立以來,一直致力於鐳射技術的研發與創新,在光伏、新型顯示和積體電路等泛半導體領域提供一體化的鐳射加工綜合解決方案。目前,公司的鐳射加工技術已廣泛應用於PERC、TOPCon、IBC、HJT、鈣鈦礦等高效太陽能電池及組件等領域,核心産品綜合全球市佔率長期保持在80%以上。其PERC鐳射消融、SE鐳射摻雜等技術直接推動了第二輪光伏産業升級,針對正在進行的第三輪光伏産業升級,也已經推出BC微刻蝕、PTP鐳射轉印、TCSE鐳射一次摻雜、LIF鐳射誘導燒結、組件封裝整線等多款關鍵新型裝備。
在新型顯示領域,帝爾鐳射發揮鐳射技術在薄膜材料、硬脆透明材料和特殊薄金屬材料等方面的優勢,推出了OLED/MiniLED鐳射修復、MicroLED鐳射巨量轉移、鐳射巨量焊接等裝備。在積體電路領域,帝爾鐳射聚焦第三代半導體、先進封裝等技術發展與革新需求,瞄準半導體領域關鍵需求和核心問題,開發多款先進半導體鐳射技術,推出了TGV鐳射微孔、IGBT/SiC鐳射退火、晶圓鐳射隱切等裝備。
帝爾鐳射深耕鐳射加工領域多年,始終堅持原始創新,探索鐳射技術應用“無人區”。2023年,帝爾鐳射研發費用達2.51億元,營收佔比達15.58%,同比2022年增長超過90%。2024年一季度,研發費用為6996萬元,相比去年同期增幅超60%。
在技術實力的加持下,2023年,公司實現營業收入16.09億元,同比增長21.49%;歸母凈利潤4.61億元,同比增長12.16%。2024年一季度,公司實現營業收入4.50億元,同比增長29.60%;歸母凈利潤1.35億元,同比增長44.48%。
洞察到TGV技術在先進封裝市場中的重要地位,以及其在實現高性能計算封裝中的關鍵作用,帝爾鐳射緊跟行業發展趨勢,已于2022年實現首臺TGV玻璃通孔鐳射設備出貨。
帝爾鐳射主要聚焦于“鐳射誘導改質+化學蝕刻”的方式,在玻璃內部形成巨量通孔結構,為後續的金屬化工藝實現提供條件,主要應用場景包括玻璃封裝基板、Mirco LED基板、IPD整合無源器件、MEMS轉接板、微流控器件、其他玻璃微結構等,支援石英、硼硅、鈉鈣、鋁硅等多種不同玻璃材質,可根據需求在基板上實現圓孔、方孔、埋孔、通孔以及微槽等多形態工藝。
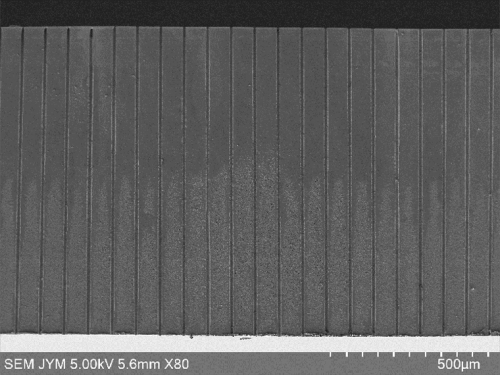
圖:100:1深徑比玻璃通孔
帝爾鐳射推出的TGV設備通過鐳射加速可控蝕刻LACE(Laser Accelerated Controlled Etching)技術,利用超高峰值功率密度整形後的鐳射束,瞬間作用在透明材料內部形成微小的鐳射改質通道,再基於改質與非改質區域的異向腐蝕速率特性,化學蝕刻形成一定深徑比、形貌可控的通孔。在深孔特性方面,最大深徑比達到100:1,最小孔徑點5µm,最小孔間距點10µm。
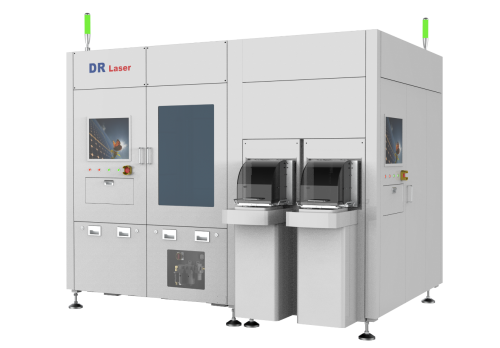
圖:ThruGlas LA-300

圖:ThruGlas LA-510
該系列設備包括ThruGlas LA-300和ThruGlas LA-510兩個平臺,LA-300適用於晶圓級封裝,支援4-12寸圓片或方片;LA-510適用於板級封裝,最大支援650*650mm基板。
TGV産業靜待起飛,生態建設是重中之重
在AI高性能晶片需求的推動下,玻璃基板封裝被寄予厚望。據Prismark統計,預計2026年全球IC封裝基板行業規模將達到214億美元,而隨著英特爾等廠商的入局,玻璃基板對硅基板的替代將加速,預計3年內玻璃基板滲透率將達到30%,5年內滲透率將達到50%以上。顯然,儘管玻璃基板被行業巨頭認為是半導體封裝遊戲規則的改變者,當前仍處於早期階段,要實現從小規模示範儘快向大批量製造平穩過渡,需要整個産業鏈的共同前進。
縱觀行業格局,目前全球玻璃基板市場高度集中,核心技術、高端産品仍掌握著國外先進企業中。News Channel Nebraska Central 2022年數據顯示,美國是最大的TGV晶圓市場,擁有約46%的市場份額,歐洲緊隨其後,約佔25%的市場份額。在TGV晶圓市場的主要參與者中,康寧、LPKF、Samtec、Kiso Micro、Tecnisco等全球前五名廠商佔有率超過70%。
值得注意的是,國內在玻璃基板封裝領域勢頭迅猛,技術發展和産能增速高於全球平均水準。有數據預測,在2024年至2026年期間,國內將擁有超過160萬片/月的玻璃晶圓設計産能。
據悉,帝爾鐳射TGV設備目前已經實現小批量訂單,同時有多家客戶在打樣試驗。未來,帝爾鐳射將繼續提升TGV鐳射通孔設備的性能指標,積極推進相關技術迭代升級以響應更高的産業需求。與此同時,公司也將繼續攜手行業夥伴,共同推動半導體封裝技術的創新與發展,在全球半導體市場上發揮更加重要的作用。

